本文來自格隆匯專欄:國君策略陳顯順 作者:方奕/陳熙淼
導讀
半導體擴產後週期疊加國產化加速,半導體新材料具盈利高彈性。當下投資環境需錨定EPS,推薦低擁擠度高確定性半導體新材料。
摘要
總量增長下行和市場風險偏好低位環境下,選股關注上一輪抱團行業中籌碼結構鬆動且有EPS預期改善的品種,半導體新材料是最好落腳。我們在之前報吿談到,在同樣面臨追求盈利確定性和低風險特徵的當下,投資者並未重新選擇抱團核心資產的原因在於上一輪核心資產的交易結構仍未明顯改善,且增速預期承壓,斜率尚且不足。擇股應着眼上一輪抱團行業中籌碼鬆動且盈利具備確定性改善預期的品種。集成電路產業鏈作為上一輪成長行情中抱團程度較高的板塊,其超配比例當前仍處高位,而半導體新材料卻處於交易結構緩解的低配狀態。分子端則又受益全球晶圓廠進入擴產後週期,產能逐步釋放帶動材料需求上行,疊加國產替代加速,盈利增長具備確定性優勢。籌碼結構集中度高,半導體主產業鏈面臨盈利優勢收斂和估值壓力。分子端看,半導體主產業鏈2021年的景氣上行來源於供需緊張和產能擴張。隨着2022年新開工晶圓廠數量減少以及高基數效應,2022年全年預期層面來看,半導體主產業鏈景氣優勢呈高位收窄。而分母端在美聯儲加息預期和通脹壓力下,高久期資產估值易受壓制。交易結構上,半導體超配比例持續上行,且2021Q4超配比例環比增幅居前,整體擁擠度仍較高,對資金的邊際吸引力出現一定程度下降。擴產後週期半導體新材料景氣上行,看好具備成長性和盈利彈性的半導體新材料。覆盤歷史,半導體設備與材料的景氣週期存在明顯相位差,設備出貨額高點領先材料企業營收6-12個月。當前2021年開工的晶圓廠已完成初步設備導入,隨着產能逐步釋放,半導體材料將成後續重點需求。落實到業績上,半導體新材料盈利能力自2020Q2進入上行期,近期盈利預期不斷上調。另一方面,其業績分歧度也低於一級行業均值,展現市場對其盈利高增的一致信心。配置角度,半導體新材料自2021Q2後超配比例下行並進入低配區間,其中晶圓材料低配程度更高,僅濺射靶材受加倉,封裝材料配置比例小幅上行。國內市場規模擴張,半導體新材料國產化進程加速。半導體材料可分為晶圓製造材料和封裝材料兩類,當前主要向高純度和新材質兩大方向發展。全球半導體材料市場規模穩步擴張,其中晶圓製造材料規模增速更快,地域上則以中國境內市場增速為全球最高。本文着重推薦晶圓材料的大硅片、光刻膠、拋光材料和濺射靶材環節。半導體在邁向先進製程的趨勢下對高端材料需求提升,當前國內市場迅速擴張,國產企業通過實現技術突破或高端產能放量推動國產替代趨勢加速。國君策略半導體新材料金股組合:重點推薦滬硅產業/立昂微/中晶科技/神工股份/江豐電子/雅克科技/南大光電/康強電子等8只股票。

1
半導體新材料:受益擴產後週期高景氣高賠率賽道
我們在報吿《下行市EPS定價錨:挖掘低風險優質金股》談到,在同樣面臨總量層面增長困境與市場風險偏好低位的環境下,本輪投資者並未重回核心資產品種抱團避險的核心原因在於,上一輪核心資產至今多數微觀市場交易結構並未顯著改善,而相較其他品種增長斜率尚且不足,預期層面又在總量下行背景下更加承壓。因此在當前選股應着重關注上一輪抱團行業中籌碼結構鬆動且有EPS預期改善的品種。集成電路產業鏈作為上一輪成長行情中備受投資者關注的板塊,其2021Q4超配比例仍處高位,籌碼結構集中。但其中半導體新材料環節卻處於交易結構緩解的低配狀態。分子端角度,本輪全球半導體擴產資本開支已進入中場,隨着產能逐步釋放,疊加國產替代趨勢加速,作為後周期的國內半導體材料環節業績具備確定性和短期高彈性,新材料中看好半導體新材料。
1.1. 高擁擠度下,半導體主產業鏈面臨盈利優勢收斂和估值的雙重壓力
2022年半導體主產業鏈面臨“盈利優勢收斂”與“估值壓制”雙重壓力。2021年半導體行業的盈利高彈性來源於供需要素疊加,供給方面,疫情打斷了原先精密的全球半導體生產分工,抑制了產品交付能力;需求方面,汽車電子、AIoT等新興科技賽道強勢崛起,疊加中美科技貿易衝突下企業的新增囤貨需求,全球對半導體芯片的需求進入了新的高峯。供需緊張下2021年半導體產業鏈全面漲價,主要晶圓製造廠商進入新一輪的資本開支高潮,進一步拉動半導體設備景氣高漲。展望2022年,根據IC insight最新預測,2022年全球半導體行業Capex將達到1904億美元,同比增長24%,相比2021年36%的增速仍有所收斂。對應到景氣變化來看,即反應為半導體2022E景氣排名儘管仍靠前,但相比2021年還是有一定程度的下降。分母端在美聯儲2022年上半年加息節奏偏鷹,能源價格進一步推高通脹壓力的背景之下,高久期的成長類型資產整體估值承受壓力。2022年半導體主產業鏈將在分子和分母兩端面臨壓力。

集成電路產業鏈以及其中半導體環節的超配比例仍處在高位,交易結構擁擠。從主動型基金的配置情況看,本輪集成電路產業鏈的超配趨勢由半導體環節驅動。自2021年一季度開始,半導體環節的超配比例不斷提升,在2021年三季度小幅減配後。四季度的集成電路產業鏈中半導體環節成為新能源車抱團初步減弱後眾多類型基金的調倉方向,其超配比例環比增幅在全國君產業鏈二級行業中排名第二。整體看半導體主產業鏈(IC設計、IC設備)的交易結構仍處在較為擁擠的狀態,對資金邊際上的吸引力較低。


1.2. 半導體新材料需求後置,擴產後週期下景氣明確
晶圓廠集中導入設備和擴產接近尾聲,後周期的半導體材料將是後續產能釋放的重點需求。2022年全球半導體的資本開支在高基數背景下增速下滑的一個重要原因是新建晶圓廠計劃的減少,根據SEMI統計,2022年新開工的晶圓廠數量將從2021年的19個降至10個。而2021年開工建設的第一批晶圓廠已經基本完成了初期的設備導入環節,北美半導體設備出貨額增速高位維持穩定。隨着第一批擴建的晶圓廠開始釋放產能,材料將成為下一階段的重點需求。從景氣週期角度看,半導體材料的景氣和半導體設備存在很明顯的相位差,北美半導體設備出貨額同比一般領先A股、台股半導體材料行業營收增速高點6-12個月。因此隨着當前設備導入已達高點,材料類企業將進入明顯的景氣上行週期,業績有望高增。

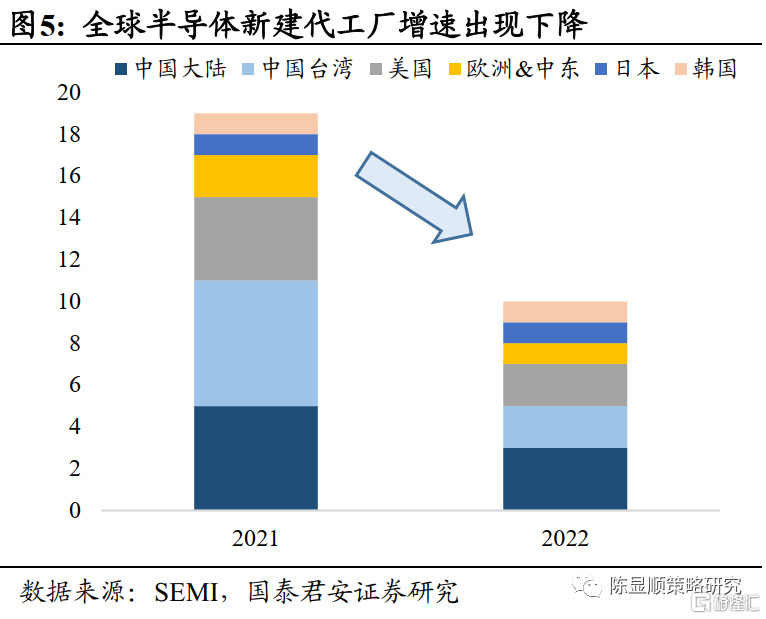

半導體新材料環節業績進入上行期,盈利預測近期同步上調。在行業景氣週期驅動之下,半導體新材料環節的業績表現自2020Q2開始進入到上行週期。2021Q3淨利潤增速同比達53%,ROE-TTM為10.6%。另一方面,市場對板塊的盈利預期在2021Q4以來持續上調,2022E最新預測水平為2021年四季度初的1.08倍,2023E是1.11倍,展現出市場對其景氣不斷抬升的預期。


高增的盈利預期下,半導體新材料環節的業績分歧度較低。2022年半導體新材料環節上市企業業績增速的中位數是43.0%,業績預期變異係數的中位數為10.7%。相比之下,A股一級行業業績分歧度的均值是11.1%,半導體新材料表現更優。展現市場對其業績高增的一致信心。

1.3. 半導體新材料相比主產業鏈交易結構更優,晶圓材料被明顯低配
半導體新材料交易結構相比主產業鏈明顯較優,晶圓製造材料明顯被低配。對比半導體主產業鏈和半導體新材料環節的超配情況,二者的配置節奏在2021Q3之前基本一致,即在2020Q3至2021Q2加倉、2021Q2至2021Q3出現一定程度減倉。不過半導體主產業鏈在Q4超配比例出現了較為明顯的上行,半導體新材料環節則延續Q3的減配趨勢繼續下降。從超配絕對值看,半導體主產業鏈明顯受到主動型基金超配,而半導體新材料環節自2019Q4後僅有2021Q2一個季度出現超配,其餘季度均是低配。從結構上看,半導體材料中的晶圓製造材料配置比例更低且配置比例下行,而封裝材料則整體處於超配且超配比例在Q4出現一定提升。從交易結構上,半導體新材料尤其是晶圓製造材料的擁擠度較低,具備吸引力。


晶圓製造材料21Q4普遍配置比例下降,濺射靶材受加倉。以基金持股佔企業自由流通市值佔比衡量基金對具體環節的持股變化情況,晶圓製造材料基金市值配置佔比在2021Q4出現明顯下降,其中僅濺射靶材的配置佔比出現明顯提升。從配置情況看,Q4基金配置佔比最高的環節是電子特氣和拋光材料。


封裝材料Q4配置比例整體上行,各細分環節均出現較明顯加倉。封裝材料的整體配置佔比在2021Q4出現了較為明顯的提升,其中封裝基板、包封材料配置比例自2021Q1以來穩步上升,陶瓷基板在經歷Q3減倉後配置比例在2021Q4出現回升。整體看基金對封裝材料的配置情況在2021年整體呈現先降後升的趨勢。


2
半導體新材料市場規模擴張,國產化進程加速
2.1. 半導體新材料板塊圖譜:晶圓材料市場規模增速更快
半導體新材料可以分為晶圓製造材料和封裝材料,其應用貫穿半導體制造和封測的全流程。在芯片製造過程中會用到硅片;清洗環節會用到高純特氣和高純試劑;沉積環節會用到靶材;塗膠環節會用到光刻膠;曝光環節會用到掩模板;顯影、刻蝕、去膠環節均會用到高純試劑,刻蝕環節還會用到高純特氣;薄膜生長環節會用到前驅體和靶材;研磨拋光環節會用到拋光液和拋光墊。在芯片封裝過程中,貼片環節會用到封裝基板和引線框架;引線鍵合環節會用到鍵合絲;模塑環節會用到硅微粉和塑封料;電鍍環節會用到錫球。

半導體新材料主要有兩個方向,即高純度和新材質。綜合展望諸多半導體材料的發展趨勢,摩爾定律下半導體制程逐漸精細,為此對於材料提出了新的需求。第一類需求即使對純度、淨度、精度等方面的要求,代表性材料為電子特氣、濕化學品、濺射靶材、拋光材料等,主要為了解決在集成電路逐漸精細的趨勢下產品因材質不純淨而出現的生產良率和精細程度不達標的問題,提升維度主要集中在工藝上。第二類需求即是舊有的材料已難以滿足新的製造需求,需要研發新的材料。典型案例如光刻膠,為適應波長逐步縮短而必須更新光刻膠的材質,其他如拋光材料和大多數封測材料均是這一發展方向。
全球半導體材料市場穩步擴張,晶圓製造材料市場規模增速更快,中國市場迅速爆發。根據SEMI的統計,2020年全球半導體材料市場為553億美元,其中製造材料市場規模達349億美元,同比增長6.5%;全球半導體封裝測試材料市場規模達204億美元,同比增長2.3%。預計到2022年,全球晶圓製造材料市場規模達392億元,CAGR6.0%;封裝材料達219億美元,CAGR4.4%。據SEMI披露,2020年晶圓材料中光刻膠和光刻膠輔助材料、濕化學制品和拋光材料增長最強勁,封裝材料則受有機基板和引線鍵合材料的高增長拉動。從地域分佈看,中國境內半導體材料市場於2020年達97.6億美元,增速12%,為全球最快增長的市場。


晶圓材料中硅片、光刻環節材料以及電子特氣份額較大,封測材料中封裝基板佔比最高。從各類材料的市場規模佔比看,半導體材料細分市場分散,其中晶圓製造材料中較為主要的材料是硅片,2020年市場規模佔比達35%。其次是光刻環節材料,光掩模、光刻膠、相關化學品分別佔比達12%/6%/8%。電子特氣佔比達13%。封測材料中,2019年佔比最大的是封裝基板,佔比達33%。其次是引線框架和鍵合線環節,分別佔比17%和16%。


2.2. 大硅片:市場快速擴張,三大驅動下國產化進程加快
半導體硅片領域的技術趨勢是向大尺寸發展,中國市場快速擴張。硅片尺寸越大,在單片硅片上製造的芯片數量就越多,單位芯片的成本隨之降低, 300mm(12英寸)半導體硅片的可使用率(衡量單位晶圓可生產的芯片數量的指標)是200mm(8英寸)硅片的2.5倍左右,且300mm 半導體硅片的終端應用主要是智能手機、計算機、雲計算、人工智能、SSD(固態存儲硬盤)等較高端領域。據SEMI統計,2020年全球半導體硅片市場為785億元,2015-2020年CAGR達9.67%。中國市場從2015年起開始騰飛,截至2020年規模增加近兩倍,從僅僅 30.5億元增長至 93.7億元,CAGR達25.18%,遠超同期全球市場增速。其中大硅片的佔比將持續提升,預計2022年300mm硅片佔有率將達到70%。
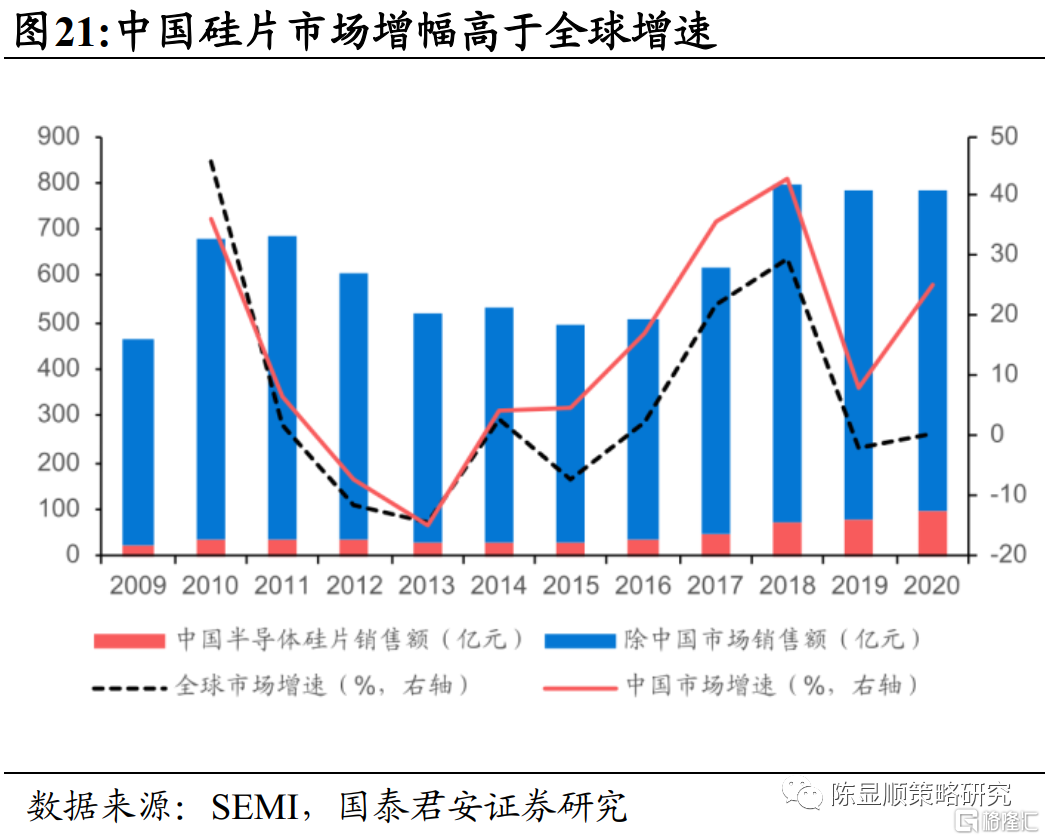


國產廠商加速成長,打破海外壟斷。2018年以前,海外半導體硅片龍頭通過併購式外延擴張使得行業集中度不斷上升,至2018年行業CR5一度高達93%。但近年來我國硅片企業的加速成長使得行業競爭格局正在改變,CR5已下降至2020年的87%。據國君電子組分析,我國硅片企業的突破受三個方面的驅動:1)外延式併購加快企業版圖擴展;2)下游需求驅動下,國內廠商積極擴張產能,順應行業趨勢,新增硅片產能聚焦12英寸;3)重摻外延片聚焦功率和模擬市場,附加值高,與國外技術差距小,利於國內廠商追趕國際龍頭。在這一趨勢下,國內廠商有望打破海外企業龍頭,實現市場份額的快速提升。

2.3. 光刻膠:國產光刻膠高端產品突破,國產化進入爆發拐點
光刻是半導體制造的核心環節,而其中光刻膠性能是決定光刻分辨率的關鍵所在。光刻的分辨率決定了芯片的最小特徵尺寸,而光刻膠作為這一環節中的核心耗材,其性能是決定工藝圖形的精密程度和良率的關鍵。光刻膠是由樹脂、光敏劑、溶劑及各類添加劑等組成的對光敏感的混合液態感光材料,其可以通過光化學反應將光掩模上的圖形轉移到被加工襯底上。光刻膠從應用場景上可分為半導體光刻膠、面板光刻膠和 PCB 光刻膠,其中擁有半導體制造的光刻膠又可根據對應的曝光波長分為g線、i線、KrF、ArF和EUV光刻膠,其曝光波長不斷縮短,而對應的光刻分辨率則不斷提升並用於更加先進製程芯片的製造。根據Trendbank披露,2020年ArF光刻膠和KrF光刻膠市場結構佔比最高,分別為44%和35%。

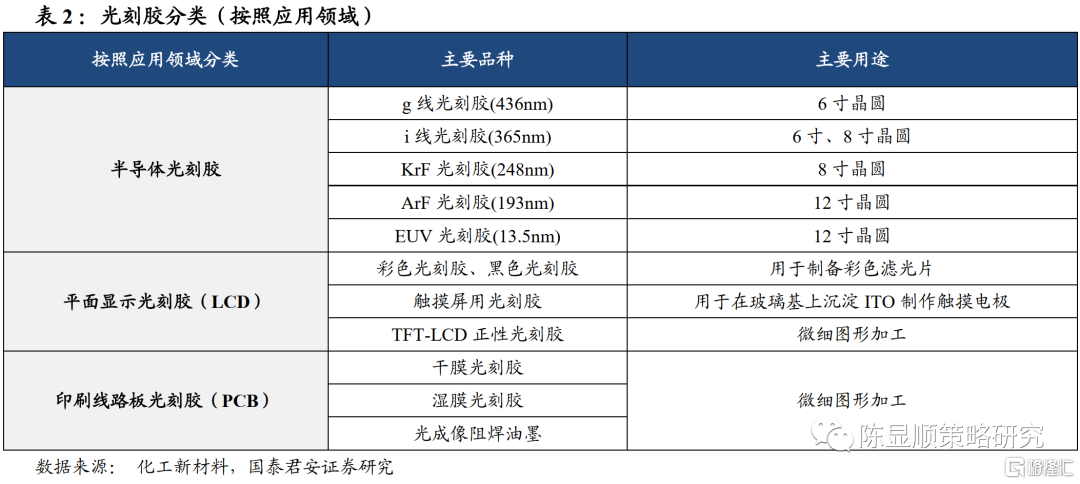
國內光刻膠市場快速擴張,國產光刻膠實現0-1的技術突破。根據華經產業研究院數據,2021年國內半導體光刻膠市場規模將達到31億元,同比增速13.1%,市場規模增速自2019年以來持續上升。從市場競爭結構上看,全球光刻膠生產高度集中於東京應化、杜邦、JSR、住友化學等日美廠商,在高端產品上集中度更高。根據國君電子組分析,光刻膠存在原材料、設備和技術三大壁壘,國內廠商在原料自主可控,相關聯動光刻機研發和定製化研發上均存在顯著差距,產品主要覆蓋低端的i/g膠。不過,隨着以南大光電為代表的國產廠商在高端光刻膠領域逐步實現量產和規模出貨,並藉助優異的產品配套開發能力成功導入國產供應鏈,光刻膠國產替代有望出現爆發。


2.4. 濺射靶材:行業景氣上行,國產替代逐步提升
國內濺射靶材行業景氣上行,國產替代逐步提升。濺射工藝是通過高能離子束轟擊靶材而使之在基底上形成功能薄膜,高純濺射靶材的品質對芯片性能有重大影響,是超大規模集成電路製造的關鍵材料。根據Techcet數據,全球濺射靶材市場2020-2024年複合增速為5%,預計2024年達到12.8億美元市場規模,而我國濺射靶材市場更是需求旺盛,預計2021-2026年複合增速為10-15%,2026年達到33億元市場規模,增速遠高於全球市場。競爭格局上,高純濺射靶材市場被日礦金屬、霍尼韋爾、東曹等海外公司掌控,我國企業市場份額仍低,但該材料的重要性倒逼國內企業奮楫爭先取得突破。國內公司如江豐電子已掌握了半導體靶材生產製造的核心技術,在高純金屬純度控制及提純技術、晶粒晶向控制技術、異種金屬大面積焊接技術、金屬的精密加工及特殊處理技術、靶材的清洗包裝技術等方面具備領先優勢,且在推動原材料供應的國產替代,礦料自給率有望提高。


2.5. 拋光材料:國內市場規模增長,國產化正在加速
先進封裝和下一代邏輯、存儲芯片提升拋光材料需求,拋光材料市場規模不斷提升。拋光材料主要包括拋光液和拋光墊,據SEMI披露,二者分別佔拋光材料市場份額的49%和33%。二者以及其他材料共同涉及的化學機械拋光一直是晶圓表面平坦化的關鍵工藝步驟,先進電子器件製造中需要平坦化的層數越來越多,而且平坦化的要求越來越高。根據Techcet數據,先進封裝以及下一代邏輯和存儲器件加速了CMP拋光材料的增長,如14 納米技術節點邏輯芯片製造工藝所要求的CMP拋光步驟數將由180納米技術節點的10次增加到20次以上,而7納米及以下技術節點的邏輯芯片製造工藝所要求的CMP拋光步驟數超過30次;對於存儲芯片,隨着由2D NAND向3D NAND演進的技術變革,也會使CMP拋光步驟數近乎翻倍,帶動了鎢拋光液及其他拋光液需求的持續快速增長。增長的拋光需求推動了市場規模的擴大,據SEMI測算,2020年全球CMP拋光材料市場規模為24.8億美元,2014-2020年CAGR為8%;2020年中國CMP拋光材料市場規模為32億元,2015-2020年CAGR約為10%。


國產企業技術上快速追趕,國產化進入快車道。拋光液領域國外企業Cabot、Hitachi、Fujimi等佔據主要市場份額,拋光墊則由美國企業Dow一家獨大。近年來,在長江存儲等國內半導體制造企業產能擴張的背景下,拋光墊打破壟斷穩步放量,拋光液加速突破穩固市場,國內廠商在CMP材料領域追趕勢頭迅猛,國產化進程駛入快車道,以拋光液領域的安集科技為例,其產品技術已經接近國際最高水平。根據SEMI的數據,公司CMP拋光液在全球市場的份額由2019年的3%左右成長到2020年的4.5%左右。拋光墊領域,鼎龍股份已通過28nm全製程驗證,先進製程驗證順利。隨着市場推進和產能建設雙管齊下,相關公司市場佔有率有望顯著提升。
3
國君策略半導體新材料金股組合
當前重點關注主產業鏈外交易結構健康,且具備確定景氣上行週期的半導體新材料環節,推薦國君策略8只半導體新材料金股組合。




